
中国粉体网讯 在科技飞速发展的当下,微机电系统(MEMS)凭借其微型化、集成化、高性能等特性,在众多领域展现出巨大的应用潜力。从消费电子中的智能手机、可穿戴设备,到汽车领域的自动驾驶辅助系统、安全气囊传感器,再到医疗行业的微型医疗器械、生物传感器等,MEMS的身影无处不在。当然,MEMS器件要充分发挥其性能优势,离不开先进的封装技术。玻璃通孔(TGV)技术作为一种新兴的封装技术,正逐渐在MEMS封装领域崭露头角,为MEMS器件的发展注入新的活力。
TGV技术是一种在玻璃基板上形成垂直通孔,并通过金属化实现电气互连的技术。其基本原理是利用特定的加工工艺,如激光诱导刻蚀法、喷砂法、光敏玻璃法等在玻璃基板上制造出高精度的通孔。以激光诱导刻蚀法为例,帝尔激光推出的TGV设备采用“激光诱导改质+化学蚀刻”的方式,利用超高峰值功率密度整形后的激光束,瞬间作用在透明玻璃材料内部形成微小的激光改质通道,再基于改质与非改质区域的异向腐蚀速率特性,通过化学蚀刻形成具有一定深径比、形貌可控的通孔。形成通孔后,再通过金属化工艺,如电镀、物理气相沉积等,在通孔内填充金属,实现电气连接。
与传统的MEMS封装技术,如陶瓷封装、塑料封装、金属封装等相比,TGV技术具有显著的优势。在成本方面,虽然TGV技术的初期设备投入较高,但随着技术的成熟和规模化生产,其成本逐渐降低,且制造工艺相对简单,有望在大规模生产中实现更低的成本;在性能方面,传统的塑料封装难以实现良好的气密性,而TGV技术能够为MEMS器件提供高气密性的封装环境,满足对密封要求较高的应用场景;在集成度方面,传统封装技术在实现芯片的高密度集成和三维集成方面存在一定的局限性,而TGV技术能够实现高互连密度和三维集成,为MEMS器件的小型化和高性能化发展提供了更广阔的空间。基于这些独特优势,TGV技术在MEMS封装中有着丰富的具体应用。
中国科学院微电子研究所开发了一种低成本的TGV制备方法,并将其应用于射频微机电系统。首先,采用CO2激光和绿色皮秒激光对玻璃进行打孔,孔径约为100μm,然后,将聚合物填充TGV通孔,再将50μm的钨针插入孔中。最后,将样品加热并放入真空罐中,等待聚合物固化。在此结构中,射频输入、射频输出和偏置线均通过钨孔,可以缩短射频互联的长度,提高响应速度。韩国檀国大学的Lee等采用电镀的方法实现了TGV的完全填充,并成功将其用于晶圆级射频MEMS封装,封装后的射频MEMS结构呈现出优异的电学性能,在40GHz频段内具有稳定可靠的射频性能,在20GHz时,表现出低的插入损耗(0.197dB)和高的返回损耗(20.032dB)。
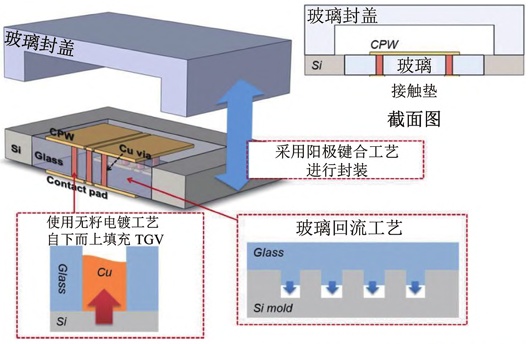
晶圆级射频微机电系统封装的示意图 来源:Lee. Through-glass copper via using the glass reflow and seedless electroplating processes for wafer-level RF MEMS packaging.
北京智能芯片微电子技术有限公司的Fu等提出了一种采用TGV工艺制造高性能MEMS加速计的方法,既能降低制造成本,又能保证器件的低噪声特性。其中,TGV工艺依靠激光钻孔,孔内金属填充基于铸造模具和化学机械抛光,封装则采用三层阳极键合工艺。所制备的加速度计抗过载能力达10000g,并且具有超高的倾斜测量性能。
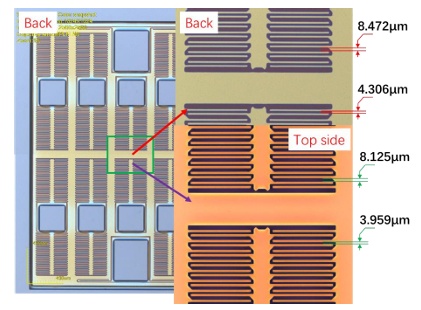
MEMS加速计的TGV刻蚀结构 来源:Fu.A high-performance MEMS accelerometer with an improved TGV process of low cost.
TGV技术作为一种具有巨大潜力的新兴封装技术,有望在未来MEMS封装领域发挥更加重要的作用。在技术发展方向上,TGV技术将朝着更高精度、更高密度、更低成本的方向发展。通过不断优化制造工艺和材料性能,进一步提高通孔的精度和密度,降低生产成本,以满足MEMS器件日益增长的性能和成本需求;在应用领域拓展方面,TGV技术将在5G通信、物联网、人工智能、医疗健康等新兴领域得到更广泛的应用。例如,在5G基站的射频前端模块中,利用TGV技术实现MEMS射频开关等器件的高性能封装,提高基站的信号处理能力;在物联网节点设备中,采用TGV技术实现MEMS传感器与微处理器等芯片的集成封装,实现设备的小型化和低功耗运行;在医疗健康领域,TGV技术将助力可穿戴医疗设备和植入式医疗设备中MEMS传感器的封装,提高设备的可靠性和生物兼容性。
参考来源:
张迅.三维集成电子封装中TGV技术及其器件应用进展
Lee.Through-glass copper via using the glass reflow and seedless electroplating processes for wafer-level RF MEMS packaging.
Fu.Ahigh-performance MEMS accelerometer with an improved TGV process of low cost.
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!














