|
参考报价:电议 型号:
产地:韩国 在线咨询
|
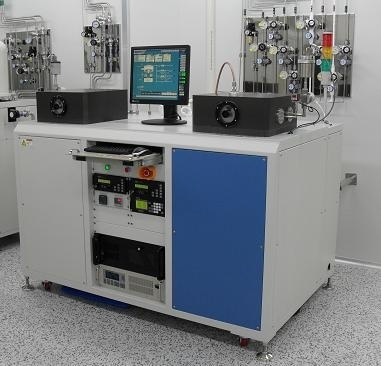
仪器简介:
该系统中的PECVD可以沉积高质量SiO2薄膜、Si3N4薄膜、类金刚石薄膜、硬质薄膜、光学薄膜等。标准配置射频(RF),可选用空阴极高密度等离子体(HCD)源、感应耦合等离子体(ICP)源。**沉积尺寸为8英寸。
使用花伞式的阴极射频等离子源,压盘可由射频或脉冲直流控制,电阻加热,循环水冷。标准配置由一路载气和两路反应气组成,也可以选配流量计。
设备规格:
计算机控制的高品质沉积设备;
射频花伞喷淋头等离子源;
**可沉积8英寸直径的薄膜;
RF偏压基底夹具;
水冷平台(water cooled platen);
一路载气和两路反应气通过流量计控制流量;
分子涡轮泵;
基本真空度10-7 Torr,200L/sec涡轮分子泵;
空气控制阀;
技术参数:
PECVD参数:
平板尺寸(Platen size) 8英寸
源直径(Source diameter) 8英寸
气路数(No. of gas feeds) 4(2反应气,1载气,1排气)
源到平板距离(Source to platen distance) 2英寸或可以调节
**平板温度(Max. platen temp.) 400℃
射频电源(RF power supply source) 600瓦,13.5 MHz
射频偏置(RF bias) 300瓦,13.5 MHz
RIE参数:
电脑控制,全能自锁
电极: 8”
电极冷却: 水冷
流量计MFC数量: 标配4个
RIE腔体:铝制,13”直径大小
工作压力: 0.02-500 mTorr, 动态压力控制
射频电源: 13.5 MHz, 600 W ,带自动调频,
真空度 : 10-7 Torr 以上,配涡沦分子泵, Baratron and WR 真空规
N2 吹扫: 整个腔体和气路
气体分散: 喷淋头式
硅片装载Wafer Load: 手动,气动式掀盖放置
等离子体源Plasma Sources: 台板射频偏压,可以产生-400V 偏压
主要特点:
柜式PECVD/ RIE系统,电脑Lab View软件控制
PECVD 等离子体源:平面喷淋头射频电极产生离子源
流量控制 :4个流量计(MFC) (针对 PECVD: NH3, 2%SiH4/Ar, O2, 和 N2O)
PECVD样品台Platen : 8”不绣钢,可加热至300C,水冷,温度可控,可配射频偏压 (选配)
PECVD沉积腔尺寸 : 14” x 14” x 14” ,不绣钢。真空度要求 5 x 10 - 7 Torr 以上
PECVD沉积腔前门可视窗口(5“直径),手动门(8”直径),和10“法兰,硅片在开门后手动放置
RIE腔体尺寸: 13” 直径,铝材质,掀盖式放置,气动式开门, 工作压力 : 0.02 to 1 Torr
铝质射频台,**至8”硅片,水冷,(冷却器未包括,需要用户提供)
喷淋头式气体分散
配加热工作时使用Baratron真空计(用于RIE)和BOC Edwards 宽频真空计(用于RIE & PECVD)
3个流量计(MFC),用于RIE(C2,BCl3,and N2) 全自动过程压力控制
VCR接头和 Nupro阀门 , 氮气线吹扫,电脑控制质量流动控制器(MFC)
德国普发公司TPH261PC型200L/sec耐腐蚀涡轮分子泵和BOC公司RV12式机械泵组合使用
射频供电: 600 W,13.5MHz 带自动调频。接入电源 220 V, 3PVAC, 20 Amp/Phase, 50/60 Hz,