一、在线检测设备-Flowdics Monitoring System
在半导体先进制程中,湿法清洗占全程工艺的30%,CMP化学机械抛光与光刻技术的协同更是高端制程突破的关键,二者均对浓度控制提出极致要求。作为半导体工艺监测领域的标杆产品,Entegris SemiChem在线浓度计早已凭借成熟的技术体系与卓越的实测表现,成为全球头部晶圆厂的核心工艺配套设备,为CMP抛光、DSP +清洗等关键制程的浓度管控奠定坚实基础。
Entegris SemiChem 在线浓度计(APM 系列)是集自动取样、分析、数据报告于一体的专业化学监测系统,实现对CMP Slurry中<1% 超低浓度H₂O₂、DSP+清洗液中100-500ppm低浓度HF的精准检测。该系统将实验室级别的精准分析技术成功落地在线监测场景,可实时校正浆料与清洗液成分,一站式解决CMP与湿法清洗的浓度管控需求,全球装机量已近3000套,在台积电、三星、SK海力士等头部晶圆厂的多工艺环节广泛应用,成为半导体制造中稳定工艺、提升良率的经典利器。
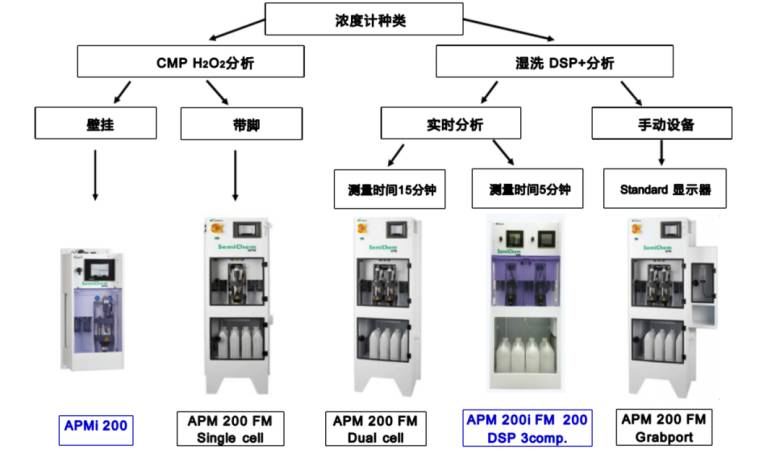
图1:Entegris SemiChem在线浓度计(APM系列)全家福
在经典款SemiChem在线浓度计的技术积淀之上,Entegris 针对半导体先进制程对多组分协同管控、工艺响应效率、设备集成性的更高要求,重磅推出进阶升级新品——SemiChem SCAPM200 三组分在线湿化学监测系统。这款升级产品在保留经典款核心精准检测技术的基础上,实现多维度性能突破,双屏精准捕捉DSP +中HF、H2SO4和H2O2关键组分的浓度动态变化,实现协同精准管控,从源头稳定清洗,为晶圆良率筑牢双重保障,成为半导体先进制程下浓度监测的全新标杆!

图2:SemiChem SCAPM200 三组分在线湿化学监测系统
应用:
铜化学机械抛光
钨化学机械抛光
湿法蚀刻
清洁
DSP+
氮化物蚀刻
PAN蚀刻
食人鱼蚀刻
HF
功能:
八路4-20mA模拟输出
16个可编程继电器,每个测量单元8个
以太网和RS232
双色触摸屏
两个测量单位
Semi S2和NRTL认证
集成试剂储存
两个采样点
六支5mL数字滴定管
多传感器输入
同一样本上的独立或平行滴定法
二、核心痛点直击:HF 与 H?O?浓度失衡,直接引发良率失控
半导体制造中,DSP+清洗液中HF与CMP研磨液(Slurry)中H₂O₂均依赖精准浓度控制,二者任一成分失衡,都会直接导致工艺失效,核心痛点集中显现:
1.1 DSP+清洗工艺:低浓度HF把控是关键,多组分协同不可缺
DSP+清洗液作为一种由去离子水、硫酸(H2SO4)、过氧化氢(H2O2)和氢氟酸(HF)组成的无机化学混合物,被广泛应用于后刻蚀工艺中的聚合物残留去除。该清洗体系通过H2O2的强氧化作用分解有机残留,同时借助HF对二氧化硅层的选择性刻蚀能力,实现对颗粒污染物和无机残留的有效清除。在DSP+清洗体系中,HF浓度的精确控制是决定工艺成败的关键因素。
HF浓度过高:导致二氧化硅层及金属表面的过度刻蚀,严重时可能导致器件短路或断路。
HF浓度过低:则导致刻蚀能力不足,无法有效去除氧化物层及颗粒污染物,致使清洗不彻底,导致器件性能退化与良率下降。
因此,HF浓度必须被严格控制在最优工艺窗口内,以平衡清洗效率与结构完整性。
1.2 CMP 抛光工艺:<1% 低浓度H?O?易分解,浓度失控直接影响抛光效果
H?O?是CMP Slurry的核心氧化剂,与晶圆表面材料反应生成易去除的软化层,是化学抛光的基础,但其化学性质不稳定,易在光照、加热下分解为水和氧气,浓度失控的影响立竿见影:
H?O?浓度过高:氧化层过厚阻碍机械研磨,抛光速率下降;过强的化学腐蚀会在晶圆表面留下划痕,增加表面粗糙度;同时加速自身分解,降低 Slurry 稳定性,还会腐蚀抛光垫、管道等设备,增加生产成本。
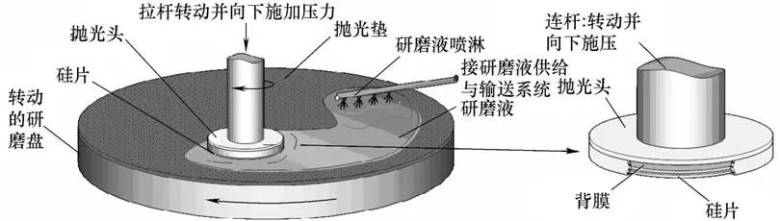
图3:CMP过程
三、行业共性难题:传统检测方式无法适配高精度、实时化需求
传统人工取样检测不仅滞后性强,更无法应对HF挥发、H?O?分解及化学反应消耗导致的双组分浓度动态衰变,既难以保障单一组分的浓度稳定,更无法实现多组分的比例协同;且市面部分改装式 “在线设备” 存在漏液、可靠性差等问题,批次间工艺一致性差,良率波动风险居高不下,更无法满足先进制程的严苛公差要求。
四、SCAPM200 核心优势:双剂精准控,多维度稳工艺提良率
Entegris SemiChem在线监测系统,依托全球近3000套装机验证,成为台积电、三星、SK 海力士等头部晶圆厂的标配设备,专为半导体微电子环境设计,完美适配DSP+清洗工艺中HF、H2SO4和H2O2三组分监测与CMP抛光工艺中H?O?的监测需求,从根本上解决多组分浓度控制难题,核心优势尽显硬核实力:
高测量精度:系统采用电化学滴定与标准加入法相结合的原理,准确度可达显示值的±0.2%,为DSP+化学组分的浓度精确控制提供了可靠数据基础。
快速响应:单次分析时间平均小于5分钟,可实时检测HF挥发等工艺偏差,确保在产品质量受损前及时纠正异常。此外,双触摸屏型号在此基础上可进一步缩短测试时间。
高运行可靠性:系统平均无故障工作时间超过8500小时,能够经受半导体制造环境的严峻考验,保障连续生产的稳定性。
主动过程控制:通过实时校正清洗液组分浓度,有效抵消化学反应和挥发导致的介质衰变,确保HF浓度始终处于最优工艺窗口,从而保障清洗效果的均匀性与重复性,为晶圆良率提升提供关键数据支撑。
在半导体先进制程持续突破的当下,工艺精度的要求愈发严苛,HF、H2SO4和H2O2的浓度管控已成为决定晶圆良率的核心环节,Entegris SemiChem SCAPM200 三组分在线湿化学监测系统的推出,精准破解了DSP +清洗与CMP抛光工艺中的组分浓度监测难题。凭借超高的测量精度、快速的工艺响应、稳定的运行表现与智能的主动控制能力,这款经全球近3000套装机验证的成熟设备,已成为头部晶圆厂的核心工艺伙伴,为半导体制造筑牢良率防线。
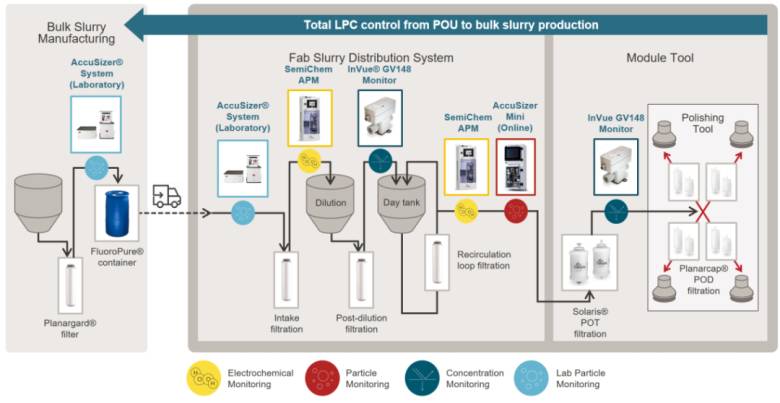
图4:Slurry的整个生命周期
从湿法清洗到CMP抛光,Entegris SemiChem SCAPM200以多工艺适配、三组分精准管控的核心能力,实现半导体关键制程的浓度实时监测与工艺主动优化,助力半导体制造企业突破制程瓶颈、稳定产品良率、降低生产成本。未来,我们将继续以前沿的工艺监测技术,赋能半导体先进制程发展,为全球半导体产业的升级提供坚实的技术支撑。







