
中国粉体网讯 在半导体产业的发展历程中,摩尔定律长期引领着芯片性能的提升与规模的扩张。然而,随着晶体管尺寸不断逼近物理极限,量子隧穿效应等问题日益凸显,传统技术路径遭遇瓶颈。玻璃通孔(TGV)技术凭借独特优势,或成为半导体突破摩尔定律束缚、开启新增长曲线的关键力量。
2.5D/3D封装工艺中的TSV技术
我们都知道,要实现芯片性能的提升就需要堆叠更多的晶体管,根据“摩尔定律”,芯片上容纳的晶体管数目每18到24个月增加一倍。过去数十年,伴随“摩尔定律”推进,单位面积晶体管密度持续攀升,驱动芯片不断向微型化演进,催生出智能手机、笔记本电脑等一系列便携式电子产品,深刻重塑了大众的生活与消费形态。
但“摩尔定律”终有触及天花板的一天。当晶圆制造工艺演进到14nm、7nm、5nm,直至当下最前沿的3nm,其有效性愈发受到严峻挑战:工艺推进举步维艰,性能提升陷入瓶颈,成本却如脱缰野马般大幅飙升。
近两年来,AI浪潮席卷全球,AI服务器对算力的需求呈井喷式爆发。强大算力的背后固然需要强劲芯片支撑,但提升芯片性能是否只能依赖光刻工艺的持续突破?答案是否定的。当前芯片已高度微型化,且服务器对轻薄化的要求远低于消费电子,一条全新思路应运而生——通过堆叠多颗芯片实现算力跃升。打个不是很形象的比喻就是一节火车头不够用那就多加两节,犹如詹天佑当年的解决思路。
由此产生了问题,芯片堆叠如何实现?
目前先进封装分为两大类:一、基于XY平面延伸的先进封装技术,主要通过重布线层工艺(RDL)进行信号的延伸和互连;二、基于Z轴延伸的先进封装技术,主要是通过硅通孔(TSV)进行信号延伸和互连。显然,芯片堆叠属于第二种。通过TSV技术,可以将多个芯片进行垂直堆叠并互连。按照集成类型的不同分为2.5D TSV和3D TSV,2.5D TSV指的是位于硅转接板上的TSV,3D TSV是指贯穿芯片体之中,连接上下层芯片的TSV。在3D TSV中,芯片相互靠近,所以延迟会更少,且互连长度缩短,能减少相关寄生效应,使器件以更高的频率运行,从而转化为性能改进,并更大程度的降低成本。TSV的尺寸范围比较大,大的超过100um,小的小于1um。随着工艺水平提升,TSV可以越做越小,密度越来越大。
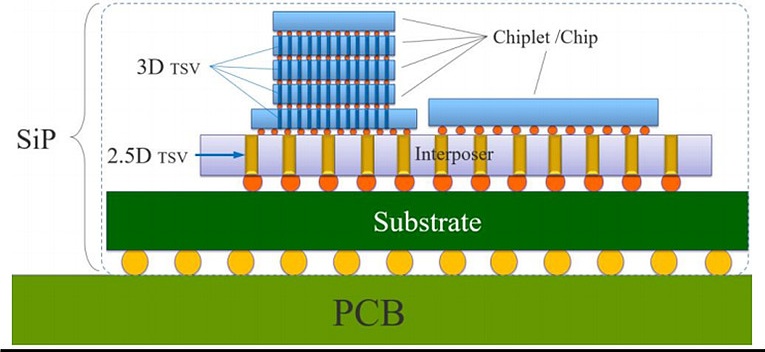
基于TSV技术的系统级封装 来源:万联证券研究所
TGV:TSV的升级
虽然在先进封装领域TSV技术较为成熟,但其存在两个主要问题。
成本高:材料上需高纯度硅晶圆及特殊绝缘、金属填充材料,损耗大;工艺复杂,含深孔刻蚀、金属填充等精细环节,设备精度要求高,采购及维护成本惊人;良率低,缺陷问题易导致成本增加。
电学性能差:硅材料属于半导体材料,传输线在传输信号时,信号与衬底材料有较强的电磁耦合效应,衬底中产生涡流现象,造成信号完整性较差(插损、串扰等)。
相较硅基转接板,玻璃转接板有诸多优势:
一、低成本:受益于大尺寸超薄面板玻璃易于获取,以及不需要沉积绝缘层,成本大大降低;
二、优良的高频电学特性:玻璃材料是一种绝缘体材料,介电常数只有硅材料的1/3左右,损耗因子比硅材料低2~3个数量级,使得衬底损耗和寄生效应大大减小,可以有效提高传输信号的完整性;
三、大尺寸超薄玻璃衬底易于获取:康宁、旭硝子以及肖特等玻璃厂商可以量产超大尺寸(大于2m×2m)和超薄(小于50μm)的面板玻璃以及超薄柔性玻璃材料;
四、工艺流程简单:不需要在衬底表面及TGV内壁沉积绝缘层,且超薄转接板不需要二次减薄;
五、机械稳定性强:当转接板厚度小于100μm时,翘曲依然较小。
TGV技术远期成长空间广阔
英伟达的H100加速计算卡采用台积电CoWoS-S 2.5D封装技术,在硅转接板上实现7组芯片互连。AMD(超威半导体)MI300采取类似布局,以CoWoS工艺在硅转接板上封装6颗GPU、3颗CPU及8组HBM内存。国内方面,壁仞科技BR100系列GPU也采用CoWoS-S封装,将2颗计算芯粒互连,实现算力的跨越式提升。
CoWoS封装的核心之一为硅转接板及TSV工艺,但其存在成本高和电学性能差等不足,而玻璃转接板及TGV工艺具有低成本、易获取、高频电学特性优良等特性,因此,TGV有望作为前者替代品,成为先进封装核心演进方向之一,叠加AI浪潮之下加速计算芯片需求高增,TGV远期成长空间广阔。其实,不止可用于转接板,搭配TGV技术,玻璃基板在光电系统集成领域、MEMS封装等领域也有巨大的应用前景,可以作为IC载板使用,以在部分领域替代现在主流的有机载板。
参考来源:
钟毅.芯片三维互连技术及异质集成研究进展
陈俊伟.玻璃在5G通讯中的应用
东方证券《先进封装持续演进,玻璃基板大有可为》
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!