中国粉体网讯
化学机械抛光(CMP)借助于抛光液中化学试剂的化学腐蚀和纳米磨粒的机械磨削双重耦合作用,可以在原子水平上实现材料的去除,可以在0.35μm及其以下尺寸器件上同时实现局部和全局平坦化,被广泛应用于光学元件、计算机硬盘、微机电系统、集成电路等领域。
CMP通过化学试剂的氧化腐蚀和磨料的机械磨损协同作用来达到纳米级别的去除,获得相对质量良好,少损伤或者无损伤的表面。工件在CMP过程中通过夹具被固定,抛光垫表面接触,抛光垫与抛光盘刚性连接并以特定的转速围绕主轴做圆周运动,夹具以及固定在其表面的工件在抛光垫与工件表面之间的摩擦力的作用下进行自转,夹具竖直方向施加一定的抛光压力,在加工过程中抛光液供给装置连续不断且均匀地向加工区域提供按一定比例配置的抛光液,工件表层在化学试剂的影响下生成具有松软特性的氧化腐蚀层,该层材料在磨料与抛光垫粗糙峰的机械磨损下被去除从而实现平坦化。
由上述CMP原理分析可知,CMP工艺包含了磨料、抛光垫、抛光液等众多影响变量。总体来说,影响CMP的因素可以分为抛光工艺参数、被加工材料以及所用耗材三大类。CMP工艺参数包括抛光压力、抛光转速、抛光温度等,还包括抛光设备所带来的振动、稳定性等一系列因素。被加工材料影响CMP的因素包括表面粗糙度、力学性能以及摩擦磨损机制等。
小小抛光垫 大大的能量
CMP抛光垫是集成电路制造CMP制程中的关键材料,抛光垫在CMP过程中承担着支撑工件、稳定抛光环境、持续输送与储藏抛光液、传递抛光压力以及带走抛光废料等作用。抛光垫物理特性和表面结构对CMP加工品质和加工速率存在较大影响,其成本占CMP总成本的三分之一左右。抛光垫产品横跨高分子化学、高分子物理、有机合成、摩擦学、精密加工等多学科领域,技术复杂度极高。

抛光垫的影响因素
抛光垫材料以及抛光垫的结构特征决定了抛光垫的物理特性。在CMP过程中,抛光垫浸泡在抛光液中会与工件和磨粒发生相对运动,由于抛光垫受到化学试剂的腐蚀与工件的磨损,这将引起抛光垫性能的下降,甚至造成抛光垫的废弃,因此抛光垫一般要求有较高的刚度、耐腐蚀性以及耐磨性,同时还应具有较好的亲水性,以用于涵养抛光液。

抛光垫常用材料分类
抛光垫的劣化
抛光垫在决定CMP性能如材料去除速率和表面质量方面起着重要作用。由于晶片施加的摩擦力和法向压力,抛光垫会发生表面磨损和基体压缩,导致表面微观结构磨损、微凸峰剪切和孔隙堵塞等。
抛光垫表面微观结构参数的变化必然会影响抛光垫-晶片的摩擦学行为和氧化层的形成及去除,不稳定的垫表面形态将导致晶片内和晶片间的加工不均匀性。抛光垫表面结构变化导致CMP过程中抛光液膜厚度、抛光界面间的实际接触面积、参与机械作用的有效磨粒数目以及抛光垫表面微凸起的变形等发生改变。
抛光垫表面的摩擦和磨损行为影响抛光垫和晶片之间的浆料膜厚度和实际接触面积、活性磨料的数量和微凸峰的变形,晶片-磨粒-垫三体互连条件将进一步改变。随着抛光时间的增加,材料冷流加剧导致抛光垫表面上釉,磨料支撑作用的减弱会降低材料的机械去除率。这种CMP过程导致抛光垫表面经历载荷以及剪切力作用,从而诱发抛光垫表面凸起发生塑性流动并趋于平面化,被称为釉化现象。
CMP过程中的化学腐蚀也会造成抛光垫的性能改变。抛光垫表面层聚氨酯链水解会对抛光垫表面的力学特性造成影响。当抛光垫浸泡在过氧化氢溶液中时,随着抛光垫使用时间的增长,弹性模量不断下降,表面的微孔层被氧化而泛黄并变形。
此外,抛光垫微孔被废屑堵塞、孔径变小,使得抛光垫孔内储藏量、运输抛光液的能力下降;同时抛光液中的磨粒的积累使得抛光垫表面变硬,抛光垫和磨料的复合弹性模量影响抛光垫的实际接触面积和磨料压痕深度,从而影响抛光效率和晶圆表面质量。
抛光垫的修整
目前,抛光垫的常规修整技术可以分为两类:非自修整技术和自修整技术。
抛光垫非自修整技术,是指借助于某种外力使抛光垫表层磨损的磨粒、空隙内存的磨屑等杂质从抛光垫表面清除出去,使新的磨粒出露,在研磨中维持磨粒的切削能力。
金刚石修整器修整技术
金刚石修整器修整主要由三部分组成:金刚石磨料、结合剂和基体。金刚石磨料在基体上通过电镀、钎焊、金属烧结和气相沉积等方法进行固结,其修整性能的好坏与抛光垫的表面状况密切相关,从而对工件加工质量产生影响。金刚石修整器修整原理是利用其表面固结的大粒径的金刚石强制使抛光垫表面部分变钝的金刚石磨粒从结合剂组织上脱落,同时也会对抛光垫表面的釉化层和磨屑层进行去除,从而使抛光垫表面暴露出新的切削刃,以达到修整的目的。
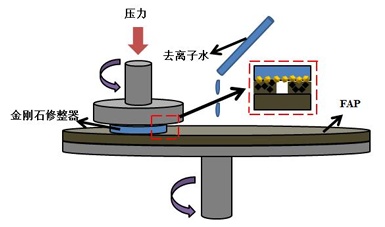
金刚石修整器修整抛光垫示意图
高压水射流修整技术
高压水射流修整技术原理是利用水射流冲击产生的剪切力,不仅可以使抛光垫表面松动或固结不好的磨料颗粒冲洗掉,而且会破坏抛光垫表面的“釉化”层,清除杂质,提高抛光垫的加工性能。

高压水射流修整抛光垫示意图
抛光垫自修整技术是指借助某种方式使抛光垫表层的基体材料适当的磨损,从而使抛光垫亚表层的磨粒得以出露,在加工过程中保持磨粒的持续出露切削的能力。抛光垫的自修整的出现,给抛光垫的修整方式注入新的方法。
抛光垫的自修整可以省去修整工序步骤,避免了修整器磨损对抛光垫造成的影响,增加了使用寿命。比如添加各种有机碱和无机盐等化学物质可提高自修整性能;使用带有疏水基团的预聚物,在抛光过程中具有自调节作用,使抛光过程稳定,不会出现水膨胀现象。
参考来源:
[1]梁斌,CMP抛光垫表面及材料特性对抛光效果影响的研究进展
[2]许庆,硬质合金刀片CMP抛光垫的劣化与改进研究
[3]陈宗昱,化学机械抛光中抛光垫的退化行为研究
[4]曹威等,化学机械抛光垫的研究进展
[5]杨亚坤,固结磨料研抛垫磨料水射流修整工艺研究
[6]鼎龙股份官网、中国粉体网
(中国粉体网编辑整理/山林)
注:图片非商业用途,存在侵权告知删除!














