华为在芯片—金刚石散热领域取得重大突破

中国粉体网讯 近年来 IT 技术飞速发展,越来越多的器件被要求封装在更小的空间内,并且运算速度对器件的工作频率提出了更高的要求,使得电子器件在工作时的热流密度迅速升高,从而温度也会不断升高。这需要采取有效的散热措施。

图片来源:pixabay
迄今为止,金刚石是已知材料中热导率最高的,并且其热膨胀系数很低,具有良好的电绝缘性,非常符合电子封装材料的应用要求。既然如此,很多人开始研究如何将金刚石这些优点应用到电子器件的散热中去。
早在2014年,华为技术团队便与厦门大学电子科学与技术学院于大全教授团队在Journal of Materials Science & Technology上发表了“基于反应性纳米金属层的金刚石低温键合技术”成果。近日,华为技术团队与于大全、钟毅老师团队、厦门云天团队合作在先进封装玻璃转接板集成芯片-金刚石散热技术领域又取得突破性进展。
成果显示,合作团队克服了微凸点保护、晶圆翘曲等行业难题,成功将多晶金刚石衬底集成到2.5D玻璃转接板(Interposer)封装芯片的背面,并采用热测试芯片(TTV)研究其散热特性。利用金刚石的超高热导率,在芯片热点功率密度为~2 W/mm2时,集成金刚石散热衬底使得芯片最高结温降低高达24.1 ℃,芯片封装热阻降低28.5%。先进封装芯片-金刚石具有极为优越的散热性能,基于金刚石衬底的先进封装集成芯片散热具有重大的应用前景。
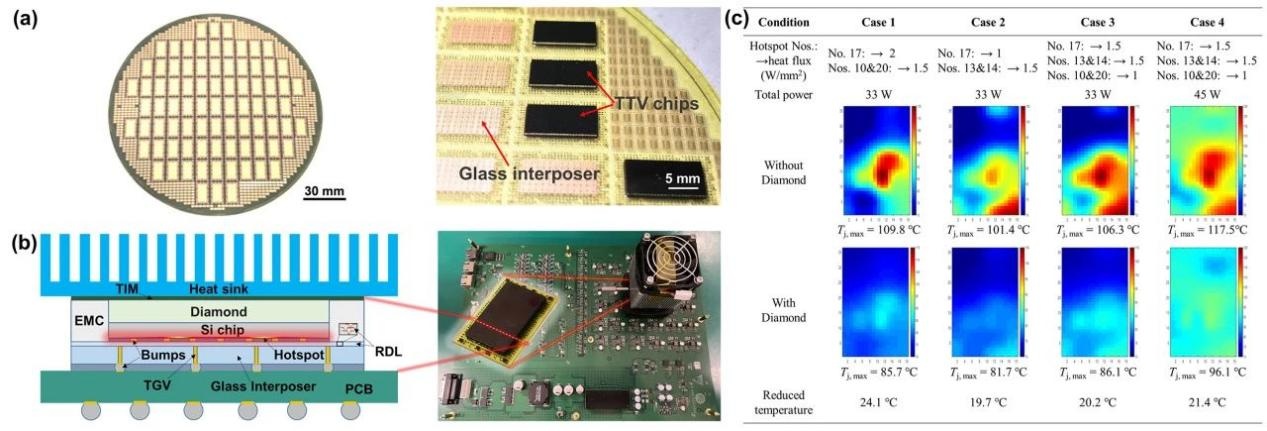
多晶金刚石衬底集成到玻璃转接板封装芯片背面及其散热性能表征
这项研究将金刚石低温键合与玻璃转接板技术相结合,首次实现了将多晶金刚石衬底集成到玻璃转接板封装芯片的背面。该技术路线符合电子设备尺寸小型化、重量轻量化的发展趋势,同时与现有散热方案有效兼容,成为当前实现芯片高效散热的重要突破路径,并推动了金刚石散热衬底在先进封装芯片集成的产业化发展。

该成果以“Heterogeneous Integration of Diamond-on-Chip-on-Glass Interposer for Efficient Thermal Management”为题发表在微电子器件封装制造领域的国际权威期刊IEEE Electron Device Letters上,并被选为当期封面文章(Front cover)及编辑精选文章(Editors’ Picks)。
资料来源:厦门大学电子科学与技术学院
(中国粉体网编辑整理/山川)
注:图片非商业用途,存在侵权告知删除
- 针对无人机散热需求,彗晶新材开发一款高性能导热凝胶
2024.04.29 - 华为固态电池,又遥遥领先?
2024.04.28 - SEMI-e 第六届深圳国际半导体展,华为 华天 长电 上海华力等头部企业6月齐聚
2024.04.28 - 2024高导热材料与应用技术交流大会
2024.04.22 - ASML光刻机卖不动了?还可能丢掉中国市场?
2024.04.20










