
中国粉体网讯 在人工智能浪潮席卷全球的当下,芯片性能成为科技竞争的核心,而玻璃基板以其独特优势,成为这场竞赛的关键。
玻璃基板:打破传统硅基材料的瓶颈
长期以来,硅基材料凭借出色的导电性和成熟工艺,在芯片制造领域占据统治地位。但随着高性能计算、人工智能和5G技术的迅猛发展,硅基材料的物理极限逐渐显现,散热瓶颈、信号延迟和成本压力严重制约芯片性能提升。在此背景下,玻璃基板凭借卓越的物理化学特性,成为半导体封装领域的破局关键。
玻璃基板具有极佳的尺寸稳定性,能够承载更大面积、更精细的图案,其热膨胀系数与硅相同,平整度极高。低介电常数是玻璃基板的另一大优势,它能大幅减少信号传播延迟和串扰,降低互连电容,实现更快信号传输,显著提升数据中心、电信和高性能计算等领域的系统效率与数据吞吐量。
巨头布局:差异化战略抢占技术高地
三星:三星在玻璃中介层的布局独具匠心,没有随大流采用510x515毫米的大尺寸玻璃面板,而是专注开发小于100x100毫米的小尺寸面板,通过加快原型验证进程,力求在市场竞争中率先发力。尽管小尺寸可能降低制造效率,但行业普遍认为,这一策略能助力三星更快将技术推向市场。
三星设备解决方案部门计划2027年实现“玻璃中介层”量产,用以替代昂贵的传统有机塑料封装基板。该项目已与美国材料巨头康宁展开合作,并联合众多中小企业,强化在先进封装领域的生态整合能力。其战略分短期与长期推进,短期聚焦先进封装应用,长期瞄准半导体制造环节。
台积电:在推进先进封装技术的进程中,台积电宣布大力开发扇出型面板级封装技术,明确选定玻璃基板作为核心材料,计划在早期阶段为英伟达生产首批基于玻璃基板的芯片。
在技术路径层面,台积电重点聚焦玻璃芯扇出和TGV工艺的研发。初期采用Chip-First方法,该方法先将芯片固定在临时载板上,再通过塑封、研磨、布线等工序完成封装结构的构建。其优势在于能实现高密度布线,控制封装厚度,不过对工艺控制要求颇高。之后过渡到Chip-Last工艺,此工艺先在玻璃载体晶圆上构建多层精细的重布线层(RDL),再进行芯片贴装与模塑,通过紫外线激光照射脱模。它的好处是可提前检测RDL,避免将芯片放置在有问题的RDL位置上,提高封装良率。后续还计划实现TGV工艺量产,在量产前,台积电将不断优化玻璃基板深宽比设计,持续提升封装性能。
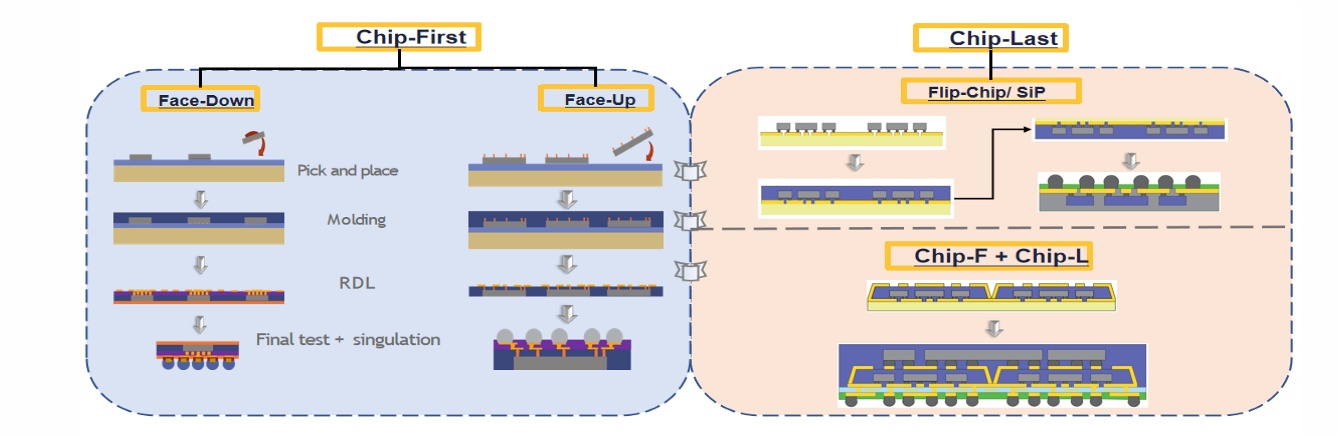
板级封装工艺路线 来源:中泰证券研究所
英特尔:英特尔早在约十年前就开始布局玻璃基板领域,通过持续高额研发投入,已取得多项关键技术突破。2023年9月,英特尔推出业界首个用于下一代先进封装的玻璃基板技术,以实心玻璃芯替代传统编织玻璃芯,大幅提升尺寸稳定性、通孔密度和信号传输速度,使芯片上裸片放置数量增加50%,显著提升多芯片系统级封装的密度和性能。
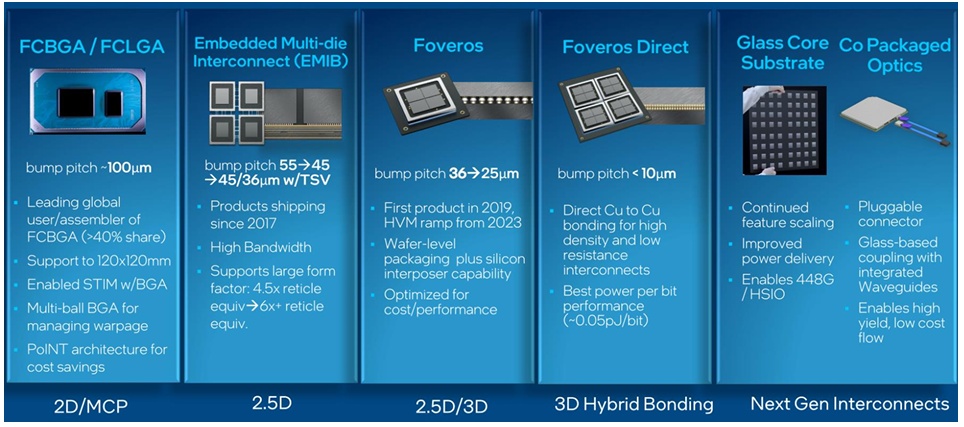
英特尔先进封装迭代路线图 来源:广发证券发展研究中心
为支撑这一技术路线,英特尔在过去十年投入约10亿美元,在美国亚利桑那州建立专门研发线和供应链,计划2026-2030年推出完整解决方案。目前,英特尔正将玻璃基板技术与共同封装光学元件结合,瞄准AI芯片和高性能计算领域,以此巩固在先进封装领域的话语权。
商业化挑战:标准缺失与技术瓶颈并存
尽管玻璃基板市场需求旺盛,但其商业化进程面临诸多阻碍。首要难题是缺乏统一标准,玻璃基板在尺寸、厚度和特性方面尚未形成全球通用规范,这给设备制造商生产通用兼容设备带来巨大挑战。
作为玻璃基板应用于先进封装的玻璃通孔(TGV)技术仍存在诸多难点。虽然欧美日在该技术开发应用上较为成熟,但在光刻实现小于2µm线距时,玻璃基板需承受更严苛加工条件,如何充分发挥光刻工具效能成为最大挑战。
这场因玻璃基板而起的芯片“封装竞赛”,已成为检验三大巨头技术实力的试金石,更将深刻重塑半导体行业未来版图。在标准化缺失、工艺复杂等重重挑战下,或许率先攻克技术难关,实现玻璃基板规模化、商业化量产的企业将抢占行业发展的制高点。
参考来源:
台积电、英特尔、三星、康宁官网
广发证券《玻璃基板从零到一,TGV为关键工艺》
中泰证券《先进封装之板级封装:产业扩张,重视设备机遇》
东兴证券《玻璃基板行业五问五答——新技术前瞻专题系列(二)》
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!