
中国粉体网讯 在半导体产业持续向高性能、小型化、低成本的方向迅猛发展的当下,先进封装技术已然成为突破摩尔定律瓶颈、推动行业前行的核心驱动力。其中,TGV(玻璃通孔)技术与TSV(硅基通孔)技术作为实现芯片间三维互连的关键方案,正展开激烈的技术竞赛,引发了整个半导体行业的高度关注。
核心技术原理:相似路径,不同材质
TSV技术的核心目标是达成芯片内部不同层面间的电气连接。其具体操作流程为,在硅晶圆上精准蚀刻出垂直贯通的微小通孔,随后在这些通孔中填充铜、钨等导电材料。
TGV技术则是在玻璃基板上构建垂直贯通的微小通孔,并填充导电材料来实现电气连接。在玻璃材料的选择上,通常会选用具有较低热膨胀系数和较高介电性能的高品质硼硅玻璃或石英玻璃。
性能特点:各有千秋,TGV高频优势凸显
信号完整性:在信号完整性方面,TSV与TGV各具特色。TSV技术依托硅材料的特性,在精确工艺控制下,能够实现高速、低噪声和低失真的信号传输。然而,随着芯片集成度向5nm以下制程不断逼近,硅材料中自由载流子引发的信号干扰问题愈发严重。特别是在6GHz以上的高频场景下,信号衰减率大大增加,这严重限制了其在5G基站、数据中心等对高频性能要求极高的领域的进一步应用。TGV技术则与之形成鲜明对比,玻璃材料的介电常数低至3.8,仅为硅材料的1/3,损耗因子低于0.001,较硅材料低2-3个数量级,能够更好地满足信号高速、稳定传输的需求。
机械性能:在机械性能方面,硅材料硬度和强度较高,但受到较大外力冲击时,容易发生脆性断裂。玻璃材料相对较脆,但其机械稳定性较强,特别是在厚度小于100μm时,翘曲程度极小。在对芯片尺寸和厚度要求较高的可穿戴设备和移动终端等应用中,TGV技术所采用的玻璃基板能够在保证机械性能的同时,实现更轻薄的设计,满足产品小型化、轻量化的发展趋势。
应用领域:市场分化,各据优势赛道
TSV应用领域:凭借在提高芯片互连密度和降低信号传输延迟方面的显著优势,TSV技术在高性能芯片领域占据了重要地位,以英伟达H100GPU为例,通过TSV技术实现的芯片互连,使其数据处理速度提升了3倍,有力地支撑了AI训练等高密度计算需求。在存储器领域,特别是堆叠式动态随机存取存储器(DRAM)的制作中,TSV技术能够实现更高的存储容量和更快的数据传输速度,满足大数据存储和快速读写的需求。在处理器和图像传感器等芯片中,TSV技术的应用也可显著提升芯片性能,使处理器能够更快地处理数据,图像传感器能够更快速、准确地捕捉和传输图像信号。
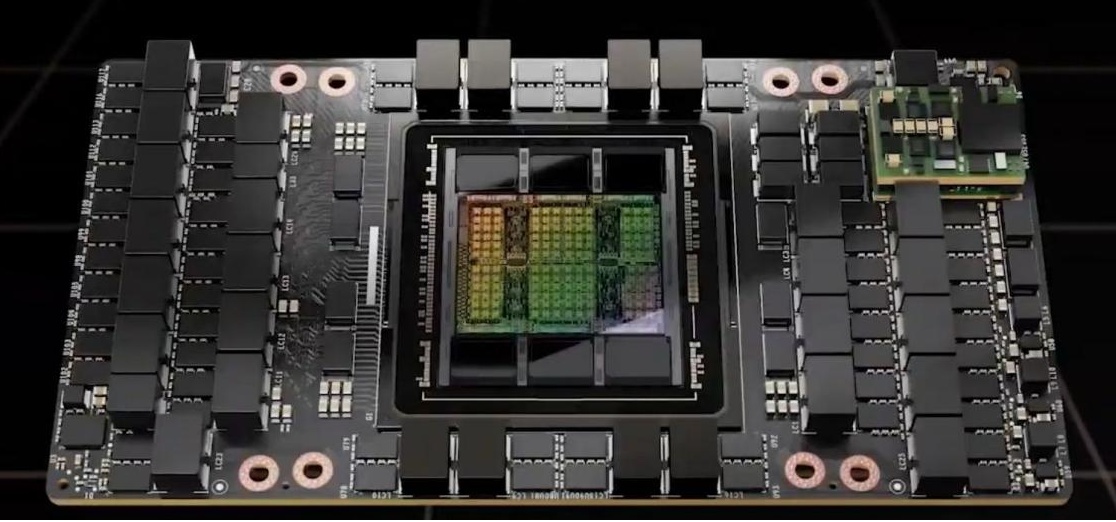
H100GPU核心 来源:英伟达
TGV应用领域:TGV技术凭借其独特的性能优势,在多个新兴领域展现出巨大的发展潜力。在射频和微波领域,TGV技术的优良高频电学特性能够有效减少信号传输过程中的损耗和干扰,提升射频系统的性能;在微机电系统(MEMS)中,TGV技术可用于实现MEMS器件与其他芯片之间的高效互连,推动MEMS技术在传感器、执行器等领域的应用发展;在先进封装领域,TGV技术作为一种新兴的纵向互连技术,有望实现芯片之间距离最短、间距最小的互联,为系统级封装(SiP)和三维集成提供更优的解决方案,推动电子产品向小型化、高性能化方向发展。
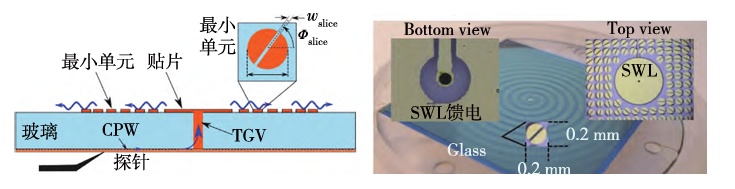
基于TGV技术的全息天线 来源:Galler.High-gain millimeter-wave holographic antenna in package using glass technology
技术瓶颈与突破:挑战并存,创新驱动前行
TSV技术瓶颈:尽管TSV技术应用广泛,但也面临着诸多挑战。其中,成本问题尤为突出,在HBM(高带宽内存)封装中,TSV成本占比接近30%,这在很大程度上制约了其大规模应用,随着芯片集成度的不断提高,硅材料在高频应用中的信号完整性问题也日益凸显,成为阻碍其进一步发展的关键因素。
TGV技术瓶颈:TGV技术同样面临难题,玻璃深孔加工难度较大,传统的激光钻孔法在制作高深宽比通孔时,效率不足硅蚀刻的1/5。玻璃材料相对较脆,在加工过程中容易出现破裂等问题,影响产品良率。
展望:技术竞争推动产业变革
随着半导体产业竞争的日益激烈,对芯片性能、尺寸和成本的要求不断提高,TSV技术和TGV技术将持续演进。未来,这两种技术可能会相互融合、取长补短,共同推动半导体封装技术向更高水平发展,为电子产品的性能提升和创新提供坚实的技术支撑,重塑全球半导体产业格局。
参考来源:
钟毅.芯片三维互连技术及异质集成研究进展
郭育华.玻璃通孔的高频传输性能
Galler.High-gain millimeter-wave holographic antenna in package using glass technology
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!














