
中国粉体网讯 在科技飞速发展的当下,光电子领域作为现代信息技术的关键支撑,正经历着前所未有的变革。从日常使用的智能手机、高清显示屏,到高端的光通信系统、先进的医疗成像设备,光电子技术无处不在,深刻影响着人们的生活与社会的发展。
随着集成电路逐步进入后摩尔时代,除利用先进封装技术突破摩尔定律的局限性外,光电子集成电路(PIC)采用全新的芯片设计思路,具有低功耗、低时延、高算力以及不易受到温度、电磁干扰和噪声变化的影响等优良特性,使其成为突破现有电子芯片设计和算力瓶颈的有效途径之一,通过光电异质集成技术实现光电子器件与传统微电子芯片的集成是未来信息技术的重要发展方向。
在硅光领域中,受限于硅材料本身的光电性能,在硅片上实现光电子系统的集成是一个很大的挑战,因此硅光子芯片与其他光子芯片或微电子芯片的集成一般采用异构集成的方式。与聚合物基板相比,玻璃基板由于其优异的光学透明度、可调控的折射率,使其在光电子互连领域具有很大的应用潜力,适合作为光子器件的封装基板,实现光波导、分束器、耦合器、透镜等光子元件的集成。此外,玻璃基板在热负荷下的尺寸稳定性以及本身良好的绝缘性也使其在光电子系统封装中备受关注。
TGV技术作为一种在玻璃基板上制造贯穿通孔以实现电气互连和信号传输的先进技术,与传统的硅通孔(TSV)技术有着相似的功能,但凭借玻璃材料自身独特的优势,在光电子领域展现出了无可比拟的应用潜力。TGV技术的诞生,为应对光电子器件朝着小型化、高性能化、高集成度发展过程中遇到的诸多难题,提供了创新性的解决方案。
德国FraunhoferIZM研究院提出了光电组合电路板(EOCB)的概念,将有源、无源和光电子元器件集成在一块玻璃基板上,并进一步提出了基于玻璃基板的光电子封装系统(pSiP)技术,先后通过激光烧蚀技术和选择性激光腐蚀(SLE)技术制备TGV,实现波导、反射镜、激光器等的三维堆叠互连。
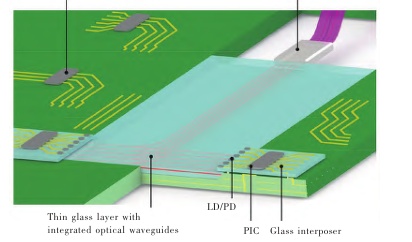

基于薄玻璃基板的EOCB示意图和实物图 来源:SCHRÖDER.Hybrid photonic system integration using thin glass platform technology
乔治亚理工学院基于超薄玻璃中间层技术,将光学和电气模块互连集成在同一块玻璃基板中,即3D玻璃基光电技术(3DGP)结构,实现了间距20μm的超高密度光学互连。康宁公司将单层玻璃基板用于共封装光学器件(CPO)中,通过嵌入式RDL和TGV实现高性能电气互连。
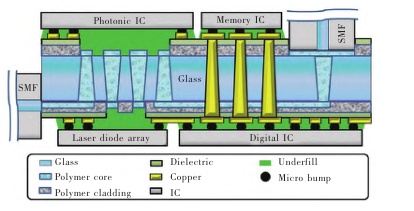
3DGP封装剖面示意图 来源:VIS.Self-aligned chip-to-chip optical interconnections in ultra-thin 3D glass interposer
尽管目前TGV技术在制造工艺还面临着一些挑战,但随着技术的不断创新和发展,这些问题或将逐步得到解决。未来,TGV技术有望与其他先进技术深度融合,在智能化应用等新兴领域发挥更大的作用,为光电子领域的持续发展注入新的活力,推动光电子产业迈向更高的发展阶段,为人们的生活和社会的进步带来更多的便利和创新。
参考来源:
刘丹.玻璃通孔技术的射频集成应用研究进展
VIS.Self-aligned chip-to-chip optical interconnections in ultra-thin 3D glass interposer
SCHRÖDER.Hybrid photonic system integration using thin glass platform technology
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!