
本文对比研究了商品化银浆体系和新银浆体系的润湿性对芯片键合性能的影响。
银浆:新型银浆体系(记为 B),其与银浆A体系的区别在于粘合促进剂的不同。
基底:环氧玻纤基材。
采用德国 KRÜSS 公司的 DSA100 测量银浆与基材的接触角。

DSA100接触角测试仪
银浆B在基材上的接触角低于银浆A,表明银浆B的浸润性良好,有利于在基板和芯片中间产生连续的银浆层。
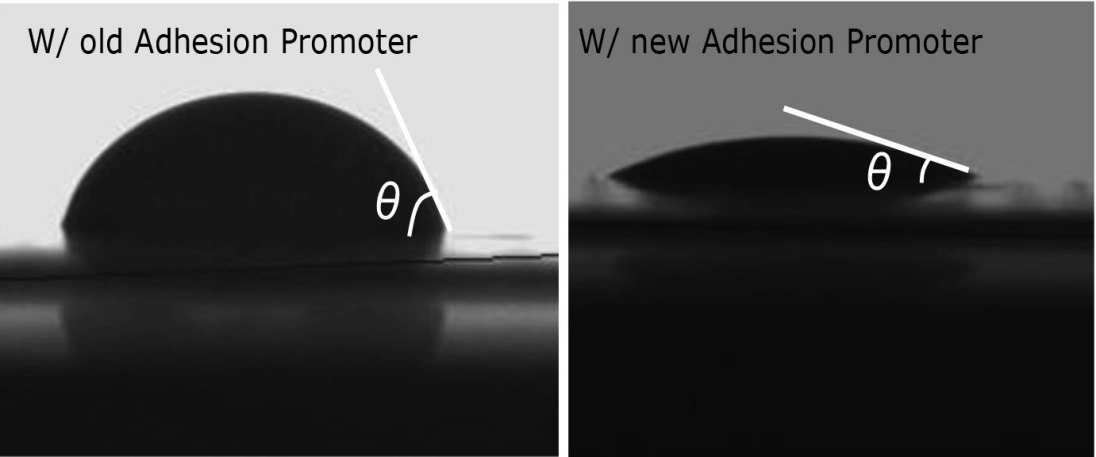
而剖面形貌分析也证实银浆 B在芯片表面形成了连续的银浆键合层。对银浆A的芯片键合层剖面进行观察,发现银浆A的键合层存在空洞,证明银浆在点胶过程中没有完全浸润基材的表面,使空气封闭在键合层中。而空气在银浆固化的过程中受热膨胀,不仅减小了界面处的银浆结合面积,减弱了键合强度,而且也导致了过高的键合层厚度。

图2,银浆 B 键合层剖面的 SEM 照片
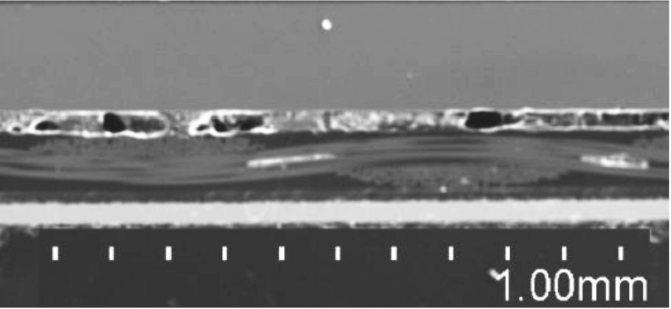
图3,银浆 A 键合层剖面的 SEM 照片
可看出减少银浆层的空洞是提高芯片键合强度的一种有效方法。合适的粘合促进剂可以帮助增加银浆在基材表面的浸润并减少界面银浆层里的空洞。
参考文献:
本文有删减,详细信息请参考原文。
堵美军,梁国正.高芯片键合质量与高生产率的新型银浆体系的研究[J].中国集成电路,2021,1-2(260-261): 63-69.