中国粉体网讯 近日,在东京国际展览中心举办的“NEPCON Japan 2026”电子制造及封装技术展览会上,英特尔首度公开展示集成嵌入式多芯片互连桥(EMIB,Embedded Multi-Die Interconnect Bridge)技术、尺寸达78mm×77mm的巨型玻璃芯基板原型。

来源:英特尔
相较于有机基板,玻璃基板凭借优异的固有特性,在先进封装等领域展现出不可替代的优势。其热膨胀系数(CTE)可精准调控至3-4ppm/K,与硅芯片高度匹配,能大幅降低热循环过程中的热应力,有效抑制封装翘曲,解决有机基板因CTE失配导致的可靠性难题;此外,玻璃基板介电常数与介电损耗更低,能减少高频信号传输延迟与串扰,适配AI、HPC芯片的高频需求,同时高刚性可有效支撑超大尺寸封装,避免基板下垂变形,高热稳定性也更适配复杂封装工艺。
英特尔该技术方案可在78毫米×77毫米的封装尺寸内,实现相当于两倍标准掩模版的面积。从垂直横截面来看,该方案采用10-2-10的叠层架构:包含10层重布线层、2层玻璃芯(厚芯)层以及10层底部重布线层/增层。即便采用如此高密度的叠层设计,依托玻璃优异的材料特性,该方案仍可实现高密度布线,这也是其核心优势。值得关注的是,英特尔已在该封装内部集成了两个嵌入式多芯片互连桥,用以实现多个计算芯片间的互连。
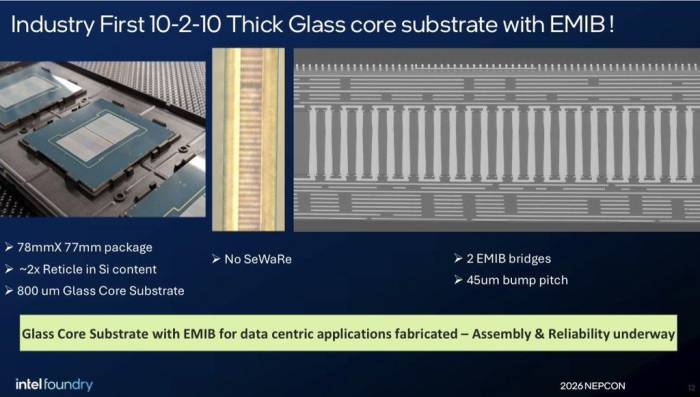
来源:英特尔
该封装的尺寸规格,以及明确标注的“无晶圆级再分布层(No SeWaRe)”标识表明,此方案专为服务器级产品设计,例如AI加速器。不难看出,此次展示的EMIB与玻璃基板整合方案,对于提升AI架构性能上限至关重要:玻璃材料可实现精细互连、更优的焦深控制,并降低机械应力。若要让AI芯片在单个“超级封装”内集成数十个芯片粒,英特尔的这一技术路径是极具可行性的优选方案之一。
此次英特尔巨型玻璃芯基板原型的公开亮相,打破了外界对其玻璃基板技术“停滞研发”的猜测,标志着该技术已从实验室走向实际应用阶段。随着2026年成为玻璃基板商业化出货的关键节点,英特尔的这一技术路径或许将支撑其晶圆代工业务争夺AI加速器市场份额,为万亿参数AI模型、高性能计算等前沿领域的突破奠定坚实基础,引领先进封装技术从“晶体管小型化驱动”向“系统级整合驱动”的深刻转型。
参考来源:
英特尔
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!


